材料系 News
10 nmの限界を突破!線幅7.6 nmの半導体微細加工を可能にする高分子ブロック共重合体の開発に成功
要点
- 極性官能基の割合が精密に制御された分子設計と精密重合法による高分子の合成により、線幅7.6 nmの半導体微細加工を可能にする高分子ブロック共重合体を開発
- 分子の自己集合により得られるナノ構造を用いるボトムアップ型の半導体微細加工技術に貢献
- 半導体回路パターンの微細化・高密度化に伴い電子デバイスのさらなる高性能化に期待
概要
東京工業大学 物質理工学院 材料系の早川晃鏡教授(材料コース 主担当)、畠山歓助教(材料コース 主担当)、難波江裕太准教授(エネルギー・情報コース 主担当)、前川伸祐大学院生、東京応化工業株式会社の佐藤和史、太宰尚宏、瀬下武広らの研究グループは、電子デバイスの高性能化を志向した10 nm以下の半導体微細加工を可能にする高分子ブロック共重合体の開発に成功した。
近年の人工知能やクラウドサービスの目覚ましい発展、スマートフォンなどの小型化および高性能化に伴って、電子デバイスに搭載される半導体チップのさらなる高性能化を実現する、より微細な加工技術の開発が重要な課題となっている。半導体基板上のフォトレジスト膜[用語1]に対して特定の波長の光を照射して凹凸パターンを描画するフォトリソグラフィはトップダウン型の半導体微細加工技術の一つであり、工業的に最も広く用いられている。現状の最先端技術として13.5 nmの波長の光を用いるEUVリソグラフィが挙げられるが、従来の露光装置では得られる凹凸パターンの不均一さや線幅[用語2]10 nm以下の微細加工を成しえないことが課題となっている。その課題を解決する目的で、現在、分子の自己集合により得られるナノ構造を用いるボトムアップ型の微細加工技術が注目されている。
本研究では、極性官能基[用語3]の割合を精密に制御した分子設計と精密重合法での高分子の合成により、ポリスチレンの化学パターンに沿ってミクロ相分離構造[用語4]を配列させた、新たな高分子ブロック共重合体を開発した。この高分子ブロック共重合体は、シリコン基板上に薄く塗られた膜中に、回路パターンの線幅7.6 nmに相当する線状構造を形成することが明らかとなった。この成果は、ボトムアップ型の半導体微細加工技術の向上に貢献するもので、半導体回路パターンの微細化と集積回路の高密度化につながることが期待される。
本研究成果は、東京工業大学と東京応化工業株式会社との共同研究によって得られ、2024年7月6日付の『Nature Communications』にオンライン掲載された。
背景
近年の人工知能やクラウドサービスの目覚ましい発展やスマートフォンなどの小型化および高性能化に伴って、電子デバイスに搭載される半導体チップのさらなる高性能化を実現する微細加工技術の向上が重要な課題となっている。半導体基板上のフォトレジスト膜に対して特定の波長の光を照射して凹凸パターンを描画するフォトリソグラフィはトップダウン型の半導体微細加工技術の一つであり、工業的に最も広く用いられている。現状の最先端技術は13.5 nmの波長の光を用いるEUVリソグラフィであるが、従来の露光装置では得られる凹凸パターンに不均一さがあり、線幅10 nm以下の微細加工が難しい。一方で、分子の自己集合により得られるナノ構造を用いるボトムアップ型は、EUVリソグラフィの欠点を補完し、より微細な加工が可能となる技術として注目されている。
ボトムアップ材料としての利用が期待されている高分子ブロック共重合体は異種の高分子鎖の末端同士が結合した特徴的な分子構造に起因して、分子の自己集合によりミクロ相分離構造と呼ばれるナノ周期構造を形成する。ミクロ相分離構造はその周期長が5~100 nm程度であることから、半導体基板に回路パターンを描画するための鋳型としての応用が期待されている。半導体基板上に薄く塗られたブロック共重合体中でミクロ相分離構造を作り出し、その片成分を除去することで残存した成分が目的の回路パターンの鋳型となる(図1)。半導体微細加工に用いられるブロック共重合体には以下の特性が求められる。
- 1.半導体基板上のブロック共重合体薄膜内において、ミクロ相分離構造が望んだ方向に向くこと。
- 2.ミクロ相分離構造の繰り返しの周期長が20 nm以下(回路パターンの線幅10 nm以下に相当)であること。
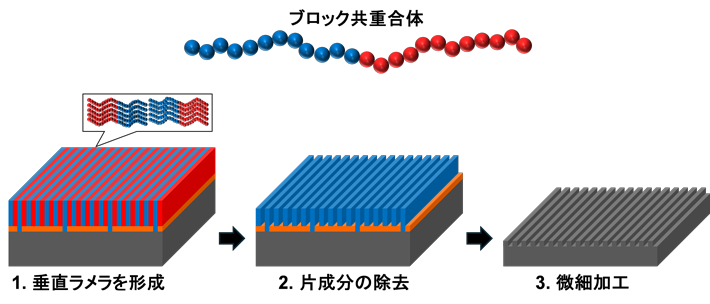
図1. ブロック共重合体をボトムアップ材料として用いる半導体微細加工の模式図
ミクロ相分離構造を微細加工の鋳型とするためには、板状構造(ラメラ構造)もしくは柱状構造(シリンダー構造)が空気界面に対して垂直に配向している必要がある。垂直配向のためには、ブロック共重合体の構成成分の空気と基板への相互作用が調製された特殊な分子設計が鍵を握っている。ボトムアップ型材料として最もよく用いられてきたポリスチレン(PS)とポリメタクリル酸メチル(PMMA)のブロック共重合体(PS-b-PMMA)は両成分の空気への相互作用が同程度であるため、垂直ラメラ構造や垂直シリンダー構造を形成する。企業や研究機関ではPS-b-PMMAに基づいた半導体微細加工プロセスの開発が進められており、業界の標準的な物質となっている。しかし、成分同士の混ざり合いにくさの指標であるFlory-Hugginsの相互作用パラメータ(χ)[用語5]の値がPSとPMMAでは小さく、互いに混ざりやすいため、PS-b-PMMAを使った線幅10 nm以下の微細加工は極めて困難であった。
研究成果
ミクロ相分離構造の周期長を下げるためにはブロック共重合体の構成成分間のχ値が大きく、互いに混ざり合いにくいことが求められる。構成成分間のχ値が大きいブロック共重合体中にはPS-b-PMMAの下限よりも小さいミクロ相分離構造が形成されるが、ミクロ相分離構造の周期長の減少と垂直配向はトレードオフの関係にある。
そこで本研究では、PSとPMMAの垂直配向性を保ちながらもχ値が大きいブロック共重合体を開発することで、線幅10 nm以下の回路パターンの鋳型となる線状構造の形成に成功した。具体的には、χ値を上げるための極性基として2,2,2-トリフルオロエチル基とヒドロキシ基をPMMAブロックに導入し、その導入割合が精密に制御されたPS-b-PMMA誘導体を設計した。
目的のブロック共重合体は精密重合法の一つであるリビングアニオン重合[用語6]と続く高分子反応[用語7]により合成された(図2)。スチレン、1,1-ジフェニルエチレン、およびメタクリル酸メチル(MMA)とメタクリル酸グリシジル(GMA)の混合物を順次反応溶液中に加え、前駆体であるPS-b-(PGMA-r-PMMA) を得た。反応溶液に加えるMMAとGMAの混合比を調整することでPGMA-r-PMMA中のPGMAの割合が約10、20、30 mol%と制御された3種類の前駆体の合成に成功した。PS-b-(PGMA-r-PMMA) と2,2,2-トリフルオロエタンチオールの高分子反応により、目的のPS-b-(PGMAF-r-PMMA) を得た。

図2. PS-b-(PGMAF-r-PMMA) の合成
得られたブロック共重合体が形成するミクロ相分離構造の構造形態とその周期長を明らかにするために、小角X線散乱(SAXS)測定と透過型電子顕微鏡(TEM)観察を行った。解析の結果、合成されたPS-b-(PGMAF-r-PMMA) は線幅10 nm以下に相当する微細なラメラ構造を形成することが明らかとなった。2,2,2-トリフルオロエタンチオールの他にエタンチオール、ベンゼンチオール、2-フェニルエタンチオール、およびシクロヘキサンチオールを用いてブロック共重合体の合成を行い、それぞれに形成されるミクロ相分離構造を比較したところ、PS-b-(PGMAF-r-PMMA) が最も微細且つ明確なラメラ構造を形成することが分かった。
PS-b-PMMAへの2,2,2-トリフルオロエチル基およびヒドロキシ基の導入量と構成成分間の反発力の相関を明らかにするために、見かけのFlory-Hugginsの相互作用パラメータ(χeff)の推定を行ったところ、官能基の導入量の増加に伴いχeffが増大することが明らかとなった。この傾向は導入された極性基の効果に加えてヒドロキシ基により生じた水素結合[用語8]によりPGMAF-r-PMMAブロック内の引力相互作用が増大したことに起因していると研究グループは考察している。
半導体微細加工材料としての特性を評価するために、表面が適切に処理されたシリコン基板上にPS-b-(PGMAF-r-PMMA) の薄膜を製膜し、加熱処理によりミクロ相分離構造の形成を図った。半導体微細加工材料には、ブロック共重合体薄膜中においてミクロ相分離構造の界面が空気界面に対して垂直に配向することが求められる。原子間力顕微鏡(AFM)を用いた薄膜表面観察より指紋状の構造が見受けられたことから、周期長12.3–18.6 nmの垂直ラメラ構造が形成されていることが分かった(図3左下)。薄膜内部の走査型電子顕微鏡(SEM)観察結果から、ラメラ構造界面は薄膜内部においても空気界面に対して垂直に配向していることが明らかとなった。PS-b-PMMAに基づいて手法が確立された誘導自己組織化はPSの化学パターンに沿ってミクロ相分離構造の配列を促し、回路パターンに適した秩序構造を与える技術である。PSの化学パターンが作製されたシリコン基板を用いた誘導自己組織化により周期長15.1 nmのラメラ構造の配列制御を行い、線幅7.6 nm相当の線状構造の形成に成功した(図3)。
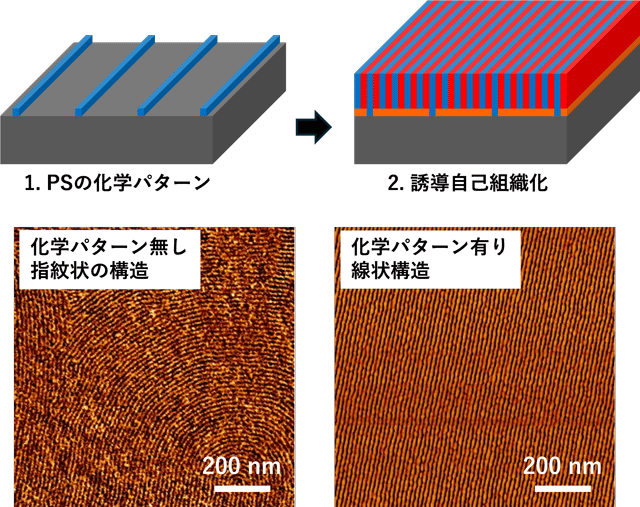
-
図3.誘導自己組織化の模式図と化学パターンの有無により得られる構造の違いを示したAFM位相像(Creative commons 4.0ライセンスに基づき、掲載論文のFigure 5および7の一部を改変して転載)
社会的インパクト
本研究で得られた線状構造の線幅はEUVリソグラフィにより得られるパターン線幅の下限値よりも小さく、10 nm以下の微細加工を可能とするものである。これにより、半導体回路パターンのさらなる高解像度化と集積回路の高密度化が進み、電子デバイスの高性能化が加速することが期待される。
今後の展開
今後は工業的に用いられている300 mmのシリコンウエハ上にPS-b-(PGMAF-r-PMMA) を塗布して誘導自己組織化により回路パターンを形成し、半導体微細加工材料としての実用化に向けた機能評価を行う予定である。
- 付記
本研究は、文部科学省科学研究費助成事業(20H02785、24H00052)の支援を受けて実施された。前川伸祐大学院生は、JST次世代研究者挑戦的研究プログラム JPMJSP2106の支援を受けて研究を実施した。
- 用語説明
[用語1] フォトレジスト膜 : フォトリソグラフィに用いられる感光性物質の膜。光の照射によって溶解性が変化し、可溶な部分を除去することで回路パターンの鋳型を与える。
[用語2] 線幅 : 回路パターンの幅の寸法。「3 nmプロセス」等のプロセスノードとは異なる。
[用語3] 極性官能基 : 電気陰性度の大きい原子と小さい原子が共有結合した置換基。原子間の電気陰制度の違いによって生じる電荷の偏りを極性と呼ぶ。極性官能基としてはヒドロキシ基(-OH)やカルボキシ基(-COOH)、アミノ基(-NH2)、トリフルオロメチル基(-CF3)が挙げられる。
[用語4] ミクロ相分離構造 : ブロック共重合体の構成成分が互いに混ざり合わず、相分離する際に形成されるナノ周期構造。ブロック共重合体の分子構造や構成成分の割合に依存して様々な形態の周期構造が形成される。
[用語5] Flory-Hugginsの相互作用パラメータ(χ) : 高分子-溶媒もしくは高分子-高分子の混ざりやすさの指標。値が正のときは成分同士が混ざり合いにくく、値が負のときは成分同士が混ざり合いやすい。
[用語6] リビングアニオン重合 : 負電荷を帯びた物質を開始剤としたビニル系モノマーの精密重合法の一つ。モノマーの生長反応の過程で連鎖移動反応や停止反応などの副反応が起こらないため分子の構造が精密に制御された高分子が得られる。
[用語7] 高分子反応 : 高分子と低分子もしくは高分子同士の反応。
[用語8] 水素結合 : 酸素原子など電気陰性度の大きい原子と共有結合している水素原子が近傍の孤立電子対をもつ原子と相互作用することで形成される非共有結合の一つ。
- 論文情報
| 掲載誌 : | Nature Communications |
|---|---|
| 論文タイトル : | Chemically tailored block copolymers for highly reliable sub-10-nm patterns by directed self-assembly |
| 著者 : | Shinsuke Maekawa, Takehiro Seshimo, Takahiro Dazai, Kazufumi Sato, Kan Hatakeyama-Sato, Yuta Nabae & Teruaki Hayakawa |
| DOI : | 10.1038/s41467-024-49839-0 |
- GPT-4を使った化学研究の課題と展望に関する研究|東工大ニュース
- 円偏光発光色 緑や青に自由自在|東工大ニュース
- 結合した2種高分子間の「つなぎ目」が鍵|東工大ニュース
- 燃料電池の非白金化に繋がる新物質を開発|東工大ニュース
- 早川晃鏡 Teruaki Hayakawa|研究者検索システム 東京工業大学STARサーチ
- 畠山歓 Kan Hatakeyama|研究者検索システム 東京工業大学STARサーチ
- 難波江裕太 Yuta Nabae|研究者検索システム 東京工業大学STARサーチ
- 早川・難波江研究室
- 難波江研究室
- 早川晃鏡研究室|物質理工学院 研究室検索サイト
- 早川研究室 —研究室紹介 #31—|材料系 News
- 材料コース(大学院課程)|教育|物質理工学院 材料系
- エネルギー・情報コース(大学院課程)|教育|物質理工学院 材料系
- 材料系(学士課程)|教育|物質理工学院 材料系
- 東京応化工業株式会社
- 研究成果一覧






